1.开元通信发布全球首款卫星/地面双模蜂窝网PAMiD,开启全域无缝连接新时代;
2.三维集成浪潮下电镀价值重估,盛美上海构筑全链条技术壁垒;
3.此芯科技完成近10亿元B轮融资,系高性能智能体CPU公司;
4.成都聚业光电完成首轮融资,聚焦光电子器件研发制造;
5.微分智飞完成数亿元A1轮融资,系飞行具身智能公司;
6.艾利特机器人完成6亿元D+轮融资
1.开元通信发布全球首款卫星/地面双模蜂窝网PAMiD,开启全域无缝连接新时代
2026年3月31日 – 以先进滤波器为优势的综合射频前端芯片供应商开元通信正式宣布,推出全球首款支持卫星通信与地面蜂窝双模工作的功率放大器模块集成双工器(PAMiD)产品——“射频前线™EM8643EN”。该产品的问世,标志着物联网终端设备迈向真正意义上的全域无缝覆盖,为应急通信、海洋运输、远程监测、智慧农业等广阔领域提供了高性能、高集成度的关键射频解决方案。
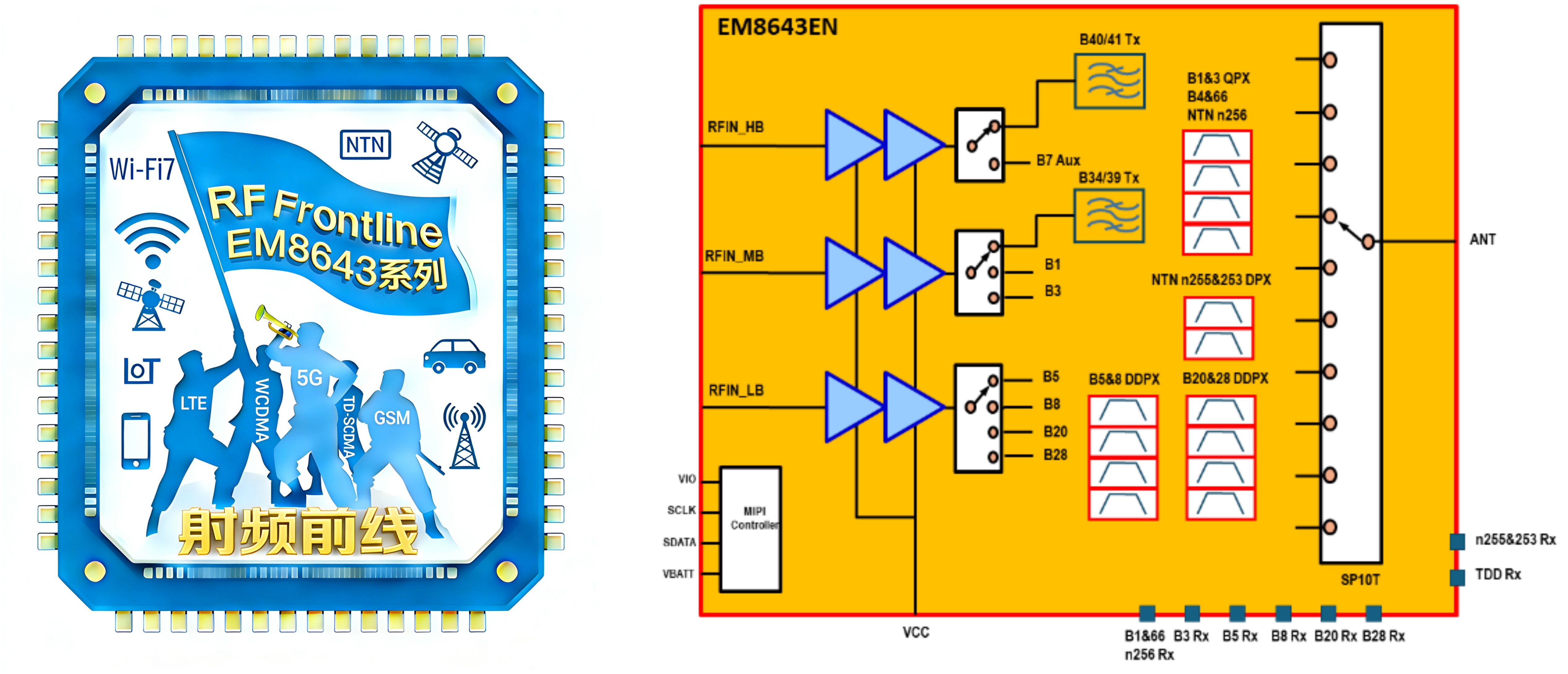
射频前线™图(左);
EM8643EN:4.0x6.8封装全球首款卫星/地面双模蜂窝网PAMiD(右)
顺应国家战略与全球标准,引领网络融合新方向
本次发布的革命性产品,诞生于一个关键的产业窗口期。在中国,“十五五”规划前期研究已将“空天地海一体化信息网络”列为重点发展方向,明确提出加快卫星互联网建设,并将其作为构建新型基础设施体系、保障国家战略安全与数字经济延伸的核心环节。国家政策的强力驱动,为产业链上下游注入了明确的发展动能。

卫星互联网行业市场规模
在国际标准层面,3GPP自Release 17起已将非地面网络(NTN)正式纳入5G标准体系,并在后续版本中持续增强对物联网(IoT NTN)的支持。这为卫星与地面网络的深度融合提供了全球统一的技术框架,确保了终端设备的全球漫游与互联互通能力。开元通信“EM8643EN”正是在Cat.1欧亚版物联频段的基础上,前瞻性适配3GPP NTN物联网标准进行设计的商用化核心器件。

卫星通信示意图
当前,全球卫星互联网星座的建设已进入白热化阶段。SpaceX的“星链”(Starlink)系统在规模部署和消费者服务之外,正积极拓展至物联网与移动手机直连领域;中国自主研发的“中国卫星网络集团(中国星网)”星座也已步入密集发射组网期,旨在构建覆盖全球、安全可控的国家空间基础设施。下游应用的爆发与运营商网络的快速成熟,对终端侧的核心射频部件提出了前所未有的高性能、高集成与低成本要求。
尽管地面蜂窝网络已经连接了全球57.8亿的人口,但地面网络实际上只覆盖了地球总面积的6%,而5G等高速率互连更是主要集中在人口密集区域。相比之下,卫星通信能够很好地在偏远地区建立网络,解决补盲和数字鸿沟问题;在边缘地区能够改善基站建设及维护成本,在人口密集区域也可以成为应急通信手段。因此,卫星通信与地面通信融合成为手机及物联网的重要发展方向。
攻克融合挑战,定义行业标杆
面对这一历史性机遇与挑战,开元通信凭借其在射频前端领域深厚的技术积累与创新设计能力,成功攻克了卫星与地面网络射频前端在频率、带宽、功率和协议上差异巨大所带来的集成难题。
“ 射频前线™ EM8643EN” 首次在单颗芯片级封装模组内,完整集成了蜂窝物联网全球版本所需的B1/3/4/5/7/8/20/28F/40/41F/66,以及卫星通信所需的n256/n255/n253/B24/B23等主流频段的功率放大器(PA)、滤波器、双工器/开关及控制电路。其核心技术创新在于:

1. 业界领先的多频多模融合架构:开元通信是国内为数不多同时出货PA和双工器的芯片厂商,其中PA累计出货近1亿颗,滤波器出货累计超过17亿颗,覆盖了手机和网通主要客户。物联网客户方面,量产客户覆盖了移远、广和通、有方、利尔达、美格、九联、日海、博实结、中云信安、富士康等三十余家厂商。采用成熟的宽带多模PA设计与频段融合滤波技术,开元通信单一射频通路能够高效适配卫星与地面网络频率及协议要求,极大简化了外围电路设计。
2. 超低功耗与高效率:针对物联网设备的长续航需求,优化了功率放大器的效率曲线及待机功耗,在卫星通信的远距离传输模式下仍能保持优异的能耗比,显著延长终端设备的工作时间。 射频前线™系列芯片实现了物联网射频芯片的超一流功耗水平。
3. 极致紧凑的尺寸:通过先进的双双工器技术与系统级封装技术,将复杂的多频段射频功能集成于尺寸仅为4.0mm × 6.8 mm的微型化模组中,相比于传统方案节约面积超过60%。助力客户开发更小巧轻便的物联网设备,确保射频指标在不同项目上快速复现,节约客户开发时间及认证成本。 射频前线™系列代表了物联网射频芯片的集成度新高度。
4. 卓越的可靠性:采用全温度补偿的滤波器技术和系统调试优化,满足工业级及车规级温度范围与可靠性标准,适应从寒冷到沙漠的各种严苛环境。浪涌指标从常规物联网芯片的标准的10V提升至20V,在复杂电网环境下能够更可靠地工作。系列产品通过将ESD敏感的SAW器件(ESD能力约300V)集成入模组,ESD防护指标提升至1000V等级。 射频前线™系列实现了物联网射频芯片的可靠性新高度。
同时,开元通信还发布了几款衍生产品:首款支持全球蜂窝物联网的PAMiD产品EM8643E(4.0mm×6.8mm),支持卫星通信的最小模组EM8643N(4.0mm×4.0mm),支持全网通蜂窝物联网的最小模组EM8643S(4.0mm×4.0mm),共同构成开元通信“射频前线™”首发产品系列,满足客户小型化低成本专用射频模组的市场需求。

赋能千行百业,共筑连接未来
开元通信董事长贾斌先生表示:“‘ 射频前线™ EM8643EN’等系列产品的发布,是开元践行‘通信改变世界’愿景的重要里程碑,是企业研发力量持续在行业前沿投入并与客户前瞻需求碰撞演化的产物。它不仅是技术的突破,更是对国家空天信息发展战略的积极响应和对3GPP全球融合标准的率先实践,同时也是物联网行业‘原生国产化创新‘的又一个案例。我们很高兴能将卫星通信的空间补盲和全时可靠,与地面蜂窝网络的存量经济性,通过一颗高度集成的射频芯片完美结合。这不仅降低了终端厂商的开发门槛和成本,更为整个物联网产业开拓了全新的应用边界,预示着真正的全球物联时代即将到来。”
该产品系列已开始向主要战略合作伙伴提供样品,预计将于2026年第三季度实现大规模量产。多家物联网模组厂商及终端设备制造商已基于 EM8643EN及衍生产品启动面向星网星链和蜂窝物联网的下一代物联网创新产品研发。
开元通信将持续投入研发,紧密跟随国家战略指引与全球技术演进,推动射频前端技术在性能、集成度与成本上的不断突破,赋能更加智能、互联的世界。
关于开元通信
开元通信技术(厦门)有限公司,是以先进滤波器为优势的综合射频芯片厂商。公司注册总部位于厦门市海沧区,目前在上海张江设有运营中心,并在北京、深圳、西安、台湾设有销售及客户支持中心。公司成立于2018年,拥有国内最齐全的BAW+SAW先进滤波器全栈自研技术,量产产品覆盖从400MHz到7.2GHz的各类通信频段及应用场景。依托先进滤波芯片及客户射频方案需求,公司的产品逐步拓展到了接收模组、放大器及定制发射模组等各类芯片。开元芯片产品在智能手机、平板电脑、物联网、网通等领域获得了广泛应用,累计出货量已超20亿颗。公司被评定为国家级高新技术企业、国家专精特新“小巨人”企业,福建省百人创业团队、厦门市未来产业骨干企业。开元通信致力于通过持续技术创新和高效产业协同,实现国产滤波芯片及射频模组的自主自强。
2.三维集成浪潮下电镀价值重估,盛美上海构筑全链条技术壁垒
在半导体产业向先进制程、三维集成加速演进,AI 算力与先进封装需求持续爆发的关键阶段,电镀技术作为芯片互联与堆叠的核心工艺,已成为产业技术攻坚的焦点。3 月 25 日,在上海举办的 SEMICON China 2026 展会上,盛美半导体设备(上海)股份有限公司(688082.SH,下称 “盛美上海”)正式发布搭载专属商标 “盛美芯盘”的八大行星系列半导体设备,以系统化、全链条布局,全面展现其在电镀等关键工艺领域的技术领先性与平台化能力。

展会同期,盛美上海工艺副总裁金一诺发表《三维芯片集成:电镀技术的挑战与机遇》主题演讲,系统解读产业趋势与技术路径,并与业界分享了公司在该核心工艺领域的深度技术洞察及针对性创新解决方案。
电镀:从幕后配套走向台前的核心工艺
金一诺在演讲中明确指出,电镀技术覆盖纳米级至微米级全尺度芯片制造与封装场景,是半导体制造流程中不可或缺的核心工艺。“从传统封装中引线框架、铜柱等基础结构制备,到先进 2.5D/3D 集成领域的 TSV 硅通孔、微凸点等精密结构成型,电镀技术贯穿全产业链环节。即便是芯片内部的铜互连,以及下一代低平均自由程非铜金属互连工艺,电镀同样发挥着关键支撑作用。”
他特别强调,伴随 HBM 存储技术快速迭代升级,电镀设备及配套工艺需求迎来爆发式增长。“三星、SK 海力士、美光三大国际存储厂商的技术路线均已明确,2026 年将推出新一代 HBM 产品,这为电镀技术带来了广阔的市场增量空间。”从传统 DRAM 向 HBM 架构升级,存算结合能力除了依靠优化架构设计外,显著提升高度依赖 TSV、微凸点等先进封装技术等互连工艺规模化集成,而相关工艺的良率控制与性能表现,很大程度上取决于电镀环节的均匀性与可靠性水平。
电镀也由此从以往的辅助配套工艺,逐步升级为决定先进封装量产能力、制约芯片产能的核心环节。
AI与存算一体浪潮 倒逼电镀技术全面升级
在 AI 芯片与存算一体芯片加速迭代的产业浪潮中,电镀技术已成为破解行业核心技术痛点、推动芯片性能突破的关键支撑。
金一诺指出,存算一体芯片发展的核心瓶颈的在于计算单元与存储单元间的互联通信效率不足,而破解这一难题,需依托三维堆叠金属化路线,实现互联工艺与芯片设计的深度协同,其中电镀技术正是该路线中不可或缺的核心支撑工艺,直接决定互联性能与芯片整体可靠性。
与此同时,AI芯片尺寸持续扩大,推动半导体产业从晶圆级制造向面板级封装转型。传统圆形晶圆在大尺寸芯片制造中边缘利用率低,有效芯片占比不足85%,推高了成本。为此,行业转向方形面板封装,310×310、510×515、600×600等规格逐渐成为主流。
但这一转型也带来了新的互联技术难题。面板互联后,器件衔接处易形成细小缝隙,助焊剂残留其中,常规物理喷淋清洗在芯片和基板之间的窄缝因液体表面张力难以充分浸润,助焊剂残留无法彻底清除,该问题成为盛美上海在面版级先进封装重点攻坚的方向之一。
金一诺将难点归纳为设备与工艺两大维度。设备方面,三维堆叠引发的翘曲问题严重,面板翘曲度可达±5毫米甚至±10毫米,甚至出现不规则波浪形,异形晶圆和面板的稳定传输、片内加工均匀性成为难点。此外,芯片线宽不断缩小、深宽比持续加大,电镀液的深孔浸润、多金属连续电镀的交叉污染防控,以及流场、电场、电化学的耦合平衡设计,都是设备研发必须突破的核心技术。
工艺方面,高深宽比结构的无空穴填充是当前最核心的挑战。目前主流客户要求的深宽比已达10:1至15:1,未来还将突破20:1,对填充材质的均匀度和致密度提出极高要求。同时,晶圆从小尺寸圆形转向大尺寸方形面板,加工面积成倍扩大,如何保证整块面板尤其是四角区域的填充效果一致,成为行业共性难题。
以平台化布局,应对多元化需求
面对半导体行业多元化、精细化的市场需求升级,盛美上海打破传统单一设备供应模式,从设备研发、工艺革新、专利攻坚等多维度协同发力,构建起系统化、全流程的一站式半导体制造解决方案,以适配行业高质量发展需求。
金一诺表示,公司始终跳出 “单一设备售卖” 的局限,深度贴合客户实际生产痛点,打造工艺深度耦合、设备协同适配的整体解决方案。这也是公司全新推出 “八大行星” 产品系列的核心逻辑 —— 将客户需求比作 “太阳”,围绕客户核心生产诉求,搭建起覆盖清洗、电镀、先进封装、炉管、化学气相沉积、面板系列等半导体关键制程的完整产品矩阵,实现全流程工艺支撑与设备协同联动。
八大行星系列产品各司其职、互补协同,构建起全面的工艺设备布局。
其中,“金星”系列作为电镀核心设备,承担先进封装、芯片互联的核心工艺重任;“地球”系列清洗设备筑牢制程根基;“水星”系列主攻涂胶显影工艺;“火星”系列炉管设备、“土星”系列等离子体化学气相沉积设备,补齐干法工艺版图;“木星”系列晶圆级封装设备、“天王星”系列面板级封装设备,深耕先进封装赛道;“海王星”系列无应力抛光设备,则着眼长远,布局下一代前沿工艺。
面板级封装是半导体产业的核心赛道,盛美上海以“金星”电镀设备为核心,配套上下游全流程工艺设备,成功攻克多项行业难题。针对面板互联后助焊剂残留难清洗的痛点,公司自主研发Ultra C vac-p负压清洗设备,凭借负压技术突破液体表面张力限制,能深入小于40微米窄缝,彻底清除残留助焊剂。这款设备凭借独创性技术(专利申请保护中),斩获由《Global SMT & Packaging》杂志颁发的全球清洁设备领域技术大奖,目前已进入客户验证阶段,预计明年实现批量投产。
从湿法工艺专家,到全域平台化方案商
金一诺回顾企业发展历程提到,盛美上海1998年成立于美国硅谷,2005年将研发、生产核心迁至上海张江,最初以清洗设备起家;2017年推出先进封装电镀设备,2019年正式切入IC电镀领域,2020年全面启动平台化战略转型。如今,公司已在上海临港、川沙建成两大研发测试与生产基地,累计斩获授权专利超五百项,技术底蕴持续夯实。

在SEMICON China 2026展会现场,盛美上海携八大行星系列重磅亮相,直观展现了企业战略转型成果:从专注湿法设备,向干湿工艺全覆盖延伸;从单点技术突破,向全域平台化布局升级。该系列覆盖清洗、电镀、涂胶显影、炉管、等离子体化学气相沉积、先进封装、无应力抛光等全流程关键工艺,凭借平台化硬实力,参与全球半导体设备市场竞争。
核心业务板块上,盛美上海依靠清洗、电镀、涂胶显影三大领域,筑起了独有的技术壁垒。清洗设备依托SAPS、TEBO、Tahoe三大核心技术,工艺覆盖率超95%,能满足各类制程需求;电镀设备秉承多阳极局部电镀等全套电镀技术,并拥有全球自主知识产权,在前道铜互连、三维堆叠、化合物半导体等领域接连实现技术突破,成为全球大马士革电镀领域仅有的两家企业之一,2024年国际市场占有率稳居全球第三;涂胶显影设备实现ArF到KrF工艺覆盖,首台国产300WPH高产出KrF涂胶显影设备已进入逻辑客户端验证,产品矩阵日趋完善。
立足湿法工艺优势,盛美上海正加速向干法设备、先进封装领域拓展。目前,炉管设备已批量供货国内头部晶圆厂,等离子体增强化学气相沉积设备凭借差异化技术完成市场导入,干法工艺布局初具规模。封装领域,公司面板级电镀、负压清洗、边缘刻蚀设备均进入客户验证环节;无应力抛光设备聚焦绿色低碳、降本增效,有望实现片内及晶粒内原子级抛光,为AI芯片先进制造储备前沿技术,助力半导体产业长远升级。
与此同时,盛美上海并不满足于已知的技术路径。AI时代对未来芯片制造工艺和设备提出了前所未有的挑战,而这些需求很多尚未被定义,对应的设备也尚未被研发。展望未来,盛美上海将保持持续差异化创新、不断突破的能力,去探索下一代设备的可能性,成为未来全球AI时代半导体装备行业的佼佼者。
3.此芯科技完成近10亿元B轮融资,系高性能智能体CPU公司
近期,此芯科技完成近10亿元人民币B轮融资,本轮融资由上海市、区两级国资平台上海IC基金和浦东创投联合领投,老股东持续加注,融资金额创下企业单笔融资历史纪录。据悉,该轮融资将重点用于现有产品的规模化商用,以及下一代高性能智能体CPU的研发与量产,加速智能体终端生态构建。
此芯科技成立于2021年,是一家专注于通用异构智能CPU芯片及高能效算力解决方案设计开发的企业,致力于为个人计算、车载应用、元宇宙基础设施等领域提供低功耗智能算力支撑,打造智能芯片2.0新范式,首款Arm架构SoC“此芯P1”已成功量产,近期还发布了专为智能体终端生态打造的CIX ClawCore螯芯系列芯片。
4.成都聚业光电完成首轮融资,聚焦光电子器件研发制造
近日,成都聚业光电科技有限公司(简称 “成都聚业光电”)宣布完成首轮融资,由上市公司国科天成与长赫投资联合投资。本轮融资将主要用于核心技术迭代、光电子材料研发攻关、光学元件产能扩建及市场渠道拓展,加速推进半导体激光器、光纤传感组件等新型光电子器件的产业化应用,完善全产业链布局。
成都聚业光电成立于 2024 年 1 月,是一家聚焦光电子器件研发制造与技术服务的专业企业,深耕光电子材料研发、光学仪器制造、电子专用设备开发三大核心赛道,专注为现代工业与消费电子市场提供高精度光学元件及定制化解决方案。
5.微分智飞完成数亿元A1轮融资,系飞行具身智能公司
近日,微分智飞(杭州)科技有限公司(简称“微分智飞”)宣布完成数亿元A1轮融资。本轮由华控基金领投,联想创投、央视基金等新股东参与,光合创投、五源资本、东方富海、华映资本、尚颀资本、深创投、长石资本及BV百度风投等老股东持续加码,认购额度超过半数。资金将重点用于产品研发与技术迭代、人才引进、行业场景拓展及现金流补充。
微分智飞专注于飞行具身智能领域,致力于打造飞行机器人“智能大脑”与通用群体智能系统。公司围绕自主导航、智能大脑、高效小脑和群体智能四大核心技术,已推出P300 PRO自主探索飞行机器人及科教产品“非凸α”,并在矿业、林业、电力、市政及应急救援等场景实现落地应用。其“世界模型导航”可通过生成式模型先推演飞行过程再执行任务;长程VLN技术赋予机器人理解自然语言与环境推理能力;基于强化学习的敏捷飞行方案,则通过单目视觉实现复杂环境下的自主避障与高速机动,降低对高成本传感器的依赖。
6.艾利特机器人完成6亿元D+轮融资
近日,艾利特智能机器人股份有限公司(以下简称:艾利特机器人)官宣完成6亿元D+轮融资,由达晨财智、元禾控股等多家机构联合参投。本轮资金将重点用于深化“一脑多形”战略,通过跨平台智能技术,让一套智能系统驱动多种形态机器人,适配多元应用场景,推动技术与产品规模化落地。
艾利特机器人成立于2018年,总部位于苏州,是国际协作机器人龙头企业与国家级专精特新 “小巨人”,公司深耕新一代人机交互协作场景,构建从底层操作系统、关节模组、关键传感器到应用工艺包的完整自主研发体系,创新推出 “VLA+T” 力矩优化感知架构,打造覆盖协作、复合、通用智能等多形态的全产品矩阵,服务汽车、3C、生物医药、新能源等多元行业
当前具身智能赛道增长迅猛,艾利特机器人AI相关业务占比达50%,业绩与盈利能力双提升。










