把一片晶圆磨到只有35微米厚,是什么概念?相当于头发丝直径的一半。AOS万国半导体旗下自有工厂—尼西半导体科技(上海)有限公司,已经建成全球首条CSP35微米功率半导体超薄晶圆工艺及封装测试生产线。这一厚度突破让功率芯片的导通电阻和热阻大幅降低,显著提升了器件的能效与散热性能,为新能源汽车、5G基站等高功率密度应用场景提供了核心支撑。
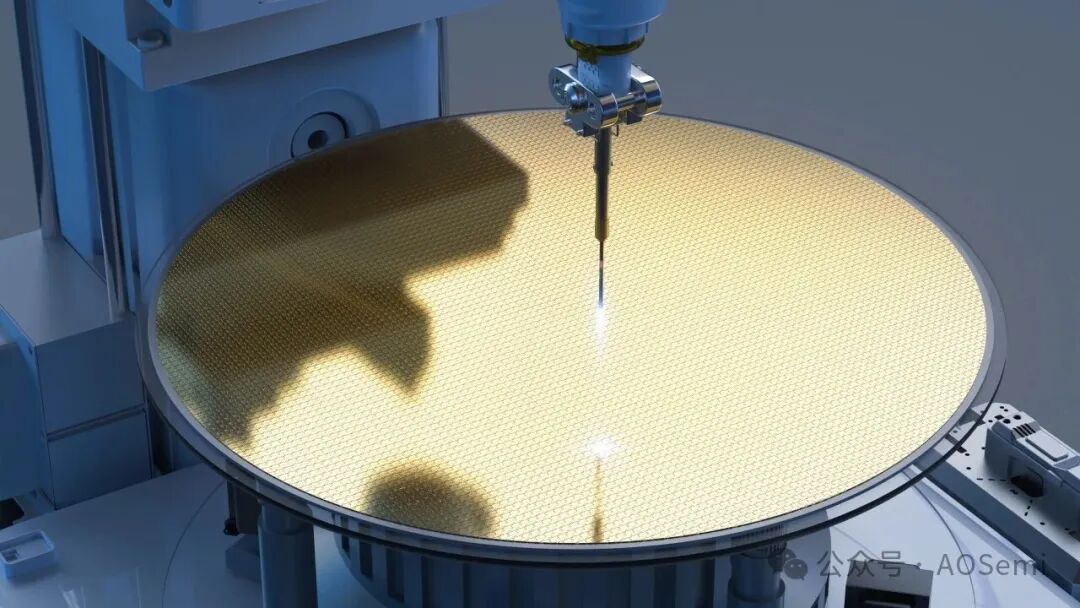
图|晶圆制造过程
豆腐上绣花,35微米见真章
晶圆越薄,性能越好,但加工难度也直线上升。晶圆薄到50微米以下后,脆得像薯片,稍微受力就可能裂开。尼西半导体通过和设备供应商一起攻关,把加工精度控制在35±1.5微米,碎片率压到0.1%以内。把研磨产生的应力损伤,通过化学腐蚀消除掉92%。切割环节也换了思路,不用传统刀片,用定制化激光切,热影响区小,切出来的良率达到98.5%。整个过程好比在豆腐上绣花,稍有不慎就前功尽弃。
40%、60%、5倍,薄芯片的三本账
芯片做薄了,好处直接体现在电和热上。载流子跑通芯片的时间缩短40%,发热量下降,导通损耗就少了。热阻比100微米的标准品下降60%,相当于给芯片装上了更好的散热片。封装环节也跟着受益——可以做双面散热,模块热阻再降30%,功率循环寿命翻了5倍。成本账也算得过来:同样一片晶圆,切出来的芯片数量多出20%,手机快充模块体积能砍掉一半,电动汽车的电控单元还能减重3公斤。
产线背后的“硬核天团”
这条产线的稳定运行,依托于研发人员在一系列关键设备上的开发和专研,以及生产过程中精良的工艺管控。键合机用于晶圆与玻璃载片的临时键合,对位误差控制在120微米以内,单日产能约400片。研磨机加工精度达0.1微米,片内厚度偏差小于2微米。激光切割机切缝宽度仅11微米,相较传统刀片切割可提升约10%的芯片有效面积利用率。解键合机通过激光实现玻璃与晶圆分离,并配套去胶工艺,破片率较低且化学品使用量小。从键合、研磨、切割到测试环节,产线均配备专用设备,其中测试环节单日产出可达12万颗成品。此外,该产线中的关键设备由公司工程师与国内设备厂商联合研发,通过协同创新实现了核心装备的自主可控,填补了国内相关技术空白。
通过精密减薄、激光切割等核心工艺,35微米超薄晶圆技术将晶圆加工从“被动减薄”升级为“主动功能化”,使芯片在电热性能、封装密度上同步提升。该产线为国产器件进入高压平台、快充等市场提供了量产底座。
关于AOS
Alpha and Omega Semiconductor Limited(AOS,中文:万国半导体) 是专注于设计、开发生产与全球销售一体的功率半导体公司,产品包括Power MOSFET、SiC、GaN、IGBT、IPM、TVS、高压驱动器、功率IC和数字电源产品等。AOS积累了丰富的知识产权和技术经验,涵盖了功率半导体行业的最新进展,使我们能够推出创新产品,满足先进电子设备日益复杂的电源需求。AOS的差异化优势在于通过其先进的分立器件和IC半导体工艺制程、产品设计及先进封装技术相结合,开发出高性能的电源管理解决方案。AOS 的产品组合主要面向高需求应用领域,包括便携式计算机、显卡、数据中心、AI 服务器、智能手机、面向消费类和工业类电机控制、电视、照明设备、汽车电子以及各类设备的电源供应。请访问AOS官网 www.aosmd.com,了解更多产品相关信息。









