1.HAIC 2025预告:光合组织All in开放架构,推动智算生态终极一跃!
2.上交所批准!艾为电子加速端侧AI等核心技术布局;
3.诺思与您相约2025中国卫星开发者论坛;
4.电镀工艺:先进封装世界的“金属骨架”锻造者;
1.HAIC 2025预告:光合组织All in开放架构,推动智算生态终极一跃!

近日,2025人工智能创新大会(HAIC 2025)媒体预沟通会召开,光合组织披露多项会议内容。其中,开放架构驱动的AI计算体系作为大会核心议题,受到产业各方广泛关注。有业内人士指出,光合组织正在大规模联动产业上下游环节,构建面向国产计算的开放式生态,进而实现全栈高效协同的产业跨层协作,推动中国智算生态完成终极一跃。
光合组织最大规模盛会意欲何为?
随着“十五五”规划日渐临近,中国人工智能产业进入体系化创新阶段,AI竞争格局发生明显变化——如果将过去的AI竞争视为算力与算法的线性竞速,局限于企业之间的较量,那么在接下来的人工智能发展规划中,全球AI赛道正转向体系与生态的全面比拼。
在此背景下,光合组织作为国家先进计算产业创新中心指导下的核心平台,一直肩负着推动科技体制机制创新、健全国产计算产业链的战略使命,其在本次大会中扮演的角色不言而喻。
根据新闻发布会披露信息,HAIC 2025是光合组织有史以来规模最大、范围最广、技术栈最全的一次年度盛会。会议面向AI计算领域,设置1场主论坛、30+场分论坛、200+场专题分享和5000㎡实景展区,将集中展现从芯片、服务器、存储、超节点、AIPC到大模型与智能体、行业应用的全栈解决方案矩阵,承担起AI国产计算开放生态的“产业链接超级平台”角色。
值得关注的是,HAIC 2025深度聚焦开放架构驱动的AI计算体系,面向大模型训练、推理部署、AI4S、具身智能等关键前沿技术方向,意在全方位推动产业链上下游多元技术、工具与应用的系统化融合,打通智算产业协同关键壁垒,实现中国AI计算生态的整体跃迁。
有分析观点指出,当前全球AI格局已从“谁的模型更快更大”,转向“谁的体系更稳更强”。在这一转折点上,中国AI计算的路线选择,既是技术命题,也是国家战略命题。光合组织选择以开放架构重新定义AI计算体系,或将受到政产双方的支持认可。
数据显示,HAIC 2025大会现已吸引超2500家产业上下游企业、机构报名,参会者预计超过4000名,覆盖芯片、大模型、智能体、软件及行业应用等全链条。显然,在产业链各方角色积极响应下,此次大会无疑也将成为中国AI计算开放架构创新的“风向标”。
开放计算路线何以成为产业共识?
“开放架构重塑AI计算体系”是HAIC 2025的核心议题。同时,光合组织在计算产业生态中聚链成势,同样有赖于“开放”属性加持。那么,开放式计算何以快速形成产业共识?
《2025 中国算力发展之AI 计算开放架构研究报告》指出,近年来,AI 大模型等算力应用场景倍增,普遍具有高并行、低延迟的双重计算需求,传统的同构计算架构已无法满足日益复杂的计算需求,而异构智算技术则呈现开放、融合、聚合的特点。
其中,“开放”要求智算中心从硬件到软件、从芯片到架构、从建设模式到应用服务都应该是开放的、标准的;“融合”是指搭载多种类型的芯片,提供多元的能力;“聚合”则要求智算中心的建设需求在超大规模前提下采用领先的技术,保证自身的先进性。
从技术路线特征来看,相较于垂直整合、由单一强者主导的封闭计算体系,开放计算本质上由多元玩家共建,具备跨层协同、广泛兼容、共创共赢等特征,更容易形成产业生态合力。
据了解,光合组织倡导的开放架构是指硬件设计、软件接口、协议规范等核心技术要素公开透明、兼容互通的技术体系,其核心价值是“打破封闭技术壁垒”。比如,该架构提供统一的技术标准与接口规范,可以让不同厂商的软硬件产品无缝适配,避免单一技术路线捆绑。
另外,参与者可以通过生态协作机制展开联合技术攻关、应用协同创新,进一步降低开放门槛,避免重复性投入,充分释放国产化研发力量;用户则能基于开放架构降低算力部署与使用成本,形成“按需取用、弹性伸缩” 的算力高效应用模式,大规模实现算力普惠。
从算力供给侧到应用需求侧,开放计算路线俨然成为产业协同共赢的最大“公约数”。尤其在全球AI产业生态和体系的较量中,开放协同的算力底座将为智算生态跃迁提供关键跳板,而国产计算体系也正表现出蓬勃的产业活性,自发结阵列队构筑中国智算的系统化竞争力。
2.上交所批准!艾为电子加速端侧AI等核心技术布局;

2025年12月4日,艾为电子向不特定对象发行可转换公司债券的申请已获上海证券交易所上市审核委员会高效审议通过!
此次可转债募资计划,标志着中国数模混合龙头,正以更快的速度,向“全球数模混合龙头”迈进。
在全球化竞争日益激烈的背景下,艾为电子正以全链路技术能力、平台化产品生态与前瞻性研发布局,向世界证明:中国芯片企业不仅能“跟跑”,更要“领跑”。
技术实力:60亿颗芯片背后的力量
能在半导体赛道快速突围,艾为电子的底气源自多年沉淀的技术硬实力。作为国内数模龙头企业,艾为电子以平台化布局打造"IC超市",产品型号近2000款,年出货超60亿颗,2025年前三季度,公司净利润实现54.98%的强劲增长,构建了从"硬件芯片+软件算法"到系统级解决方案的全链路能力,在音频功放、线性马达驱动、OIS光学防抖等细分赛道保持全球领先地位。这不仅是公司转型成效的有力证明,也为后续发展打开了更广阔的空间。
接下来的故事,需要一个更大的舞台。
战略布局:打造未来“云端芯城”
这个舞台的核心,是坐落于上海闵行区、计划于2028年投入使用的全球研发中心,艾为电子以“云端芯城”为整体构想,打造面向未来的集成电路产业创新高地。
该中心不仅以建筑语言传递科技内涵——建筑立面融入了芯片与晶圆的设计元素,在夜间,通过一套精密的可编程灯光系统,整个建筑群可以变幻出流光溢彩的芯片电路图案,成为一座兼具科技高度与人文温度的“科幻地标”。


作为集研发、展示与生态融合为一体的综合型平台,该中心秉持“上载科技,下载自然”理念,内部规划了科技展示中心与绿色交流区域,意在打造吸引国际客户、合作伙伴与高端人才的“科技文化会客厅”,展现艾为电子以创新驱动行业发展的坚定决心。在构建专业化实验室的同时,精心营造绿色花园式工作环境,并融入网球场、室内篮球馆、游泳池、健身房、撸猫馆等人文关怀空间,在这里,创新不止源于硬核科技,更生长于自由、健康与松弛的土壤之中,彰显艾为电子以人本驱动科技、以创新驱动行业的坚定决心。
技术布局:撬动未来三大产业方向
在资金与物理空间布局不断完善的同时,技术领域的创新攻坚正成为驱动发展的核心引擎。
其中,端侧AI芯片作为人工智能产业链的关键环节,展现出广阔的发展前景。该领域正处于规模化应用的前夜,正成为推动产业升级的重要赛道。在市场需求与政策支持的双重驱动下,端侧AI芯片产业迎来快速发展。据权威预测,全球端侧 AI 市场将在2025-2029年从3219亿元跃升至1.22万亿元,艾为电子看准的正是智能穿戴、AIoT设备的爆发性需求,在研的MCU+NPU等低功耗、高算力AI芯片,旨在让AI能力脱离云端,在耳机、手表、家电等终端设备上真正“活”起来。这不仅是单一芯片产品的技术突破,更是为万物智能互联的“端侧革命”提供底层动力,其背后所牵引的是具有巨大潜力的未来产业生态,对培育新质生产力、构筑科技创新竞争优势具有战略意义。
在确定性更高的汽车电子领域,艾为电子正稳步推进产业布局,并取得一系列扎实进展。公司已实现量产的车规级音频功放、氛围灯、射频开关、电源管理芯片等产品,凭借优良性能与可靠性,逐步进入比亚迪、广汽等国内主流车企供应链体系。在广汽昊铂GT-攀登版等强调芯片全国产化的智能车型中,艾为电子相关产品为智能座舱听觉体验提供了关键技术支撑。这些进展表明,公司正稳步从消费电子领域延伸至技术门槛更高、认证要求更严的汽车电子赛道,展现出自身在芯片设计与系统集成方面的综合实力,也为提升我国汽车芯片供应链的自主可控能力提供了有力支撑。
在制造业智能化转型的关键领域,运动控制技术的重要性日益凸显,其发展水平直接关系到工业装备的精确性、稳定性和智能化程度。艾为电子聚焦智能电机驱动与高精度传感技术,所研发的BLDC电机驱动芯片及磁传感器芯片,逐步成为工业机器人、自动化设备等高端装备的核心控制部件。这一布局不仅是产品线的延伸,更标志着公司在数模混合信号芯片方面的设计能力,已系统性地嵌入工业4.0与智能制造的关键环节。目前,艾为电子运动控制类芯片已在工业自动化、机器人、无人机等领域形成规模化应用,工业类业务逐步成长为支撑公司营收的重要板块。随着国家持续推进工业领域设备更新与智能制造升级,高端运动控制芯片的国产化需求不断增强。艾为电子依托在电机控制算法、多传感器融合等核心技术的积累,积极参与推进国产替代进程,致力于在技术门槛高、客户黏性强的工业控制领域构建可持续的竞争力。
展望未来,向世界出发
展望未来,艾为电子将继续秉持“技术立企、创新驱动”的理念。随着全球研发中心的落成与可转债项目的推进,公司将进一步夯实从芯片设计到系统级解决方案的全链路竞争力。艾为电子立志成为全球数模混合芯片领域的领军者,致力于以创新的芯片技术为根基,携手全球伙伴,共同构建开放共赢的芯片产业创新生态,为中国乃至全球的科技创新注入强劲的“芯”动力。
3.诺思与您相约2025中国卫星开发者论坛;
2025第二届中国卫星开发者论坛暨商业航天产业技术交流会将于2025年12月11至12日在上海举办!本次展会,诺思将展出多款应用于北斗系统与卫星通信领域的高性能 ICBAR 滤波芯片产品。 诚邀广大客户及业界同仁莅临诺思展位交流洽谈!

展会时间、地点
2025年12月11至12日
上海南翔温德姆酒店上海市嘉定区槎溪路789号
扫码报名

关于诺思
诺思(天津)微系统有限责任公司创立于2011年,是国内首家以ICBAR(干涉耦合体声波谐振器)滤波芯片为核心业务,集设计研发、晶圆制造与销售服务于一体的IDM企业。目前,已研制和生产的成熟产品约750余款,覆盖10GHz以下的通信频段,产品形式包括滤波器、双工器、多工器以及模组等。公司产品主要应用于移动通信、基站服务、北斗导航、卫星通信及汽车电子等战略新兴领域。
诺思在北斗卫通领域积累了十余年的生产研发经验,前期开发的产品在业内广受好评,并实现规模交付。
低温漂、高滚降
· 北斗III代S频段RSFK2492F016B1:
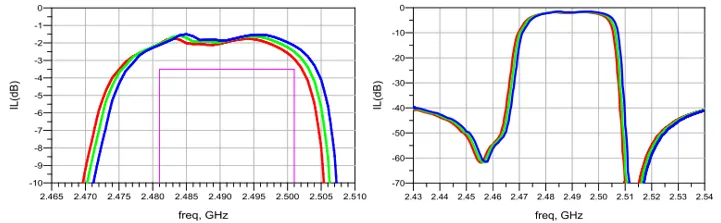
此款产品采用温度补偿(TCF)结构,温度漂移系数在±5ppm/℃以内,大大降低了滤波器在高低温下的温度漂移,从而保证产品具有高滚降,高邻带抑制等特性。
高功率容量≥10W
· 北斗III代L频段产品RSFK1268F020B4:

低插损、高抑制、高功率≥5W
· 卫星通信双工器RSDKN253F007B1:

三种封装形式
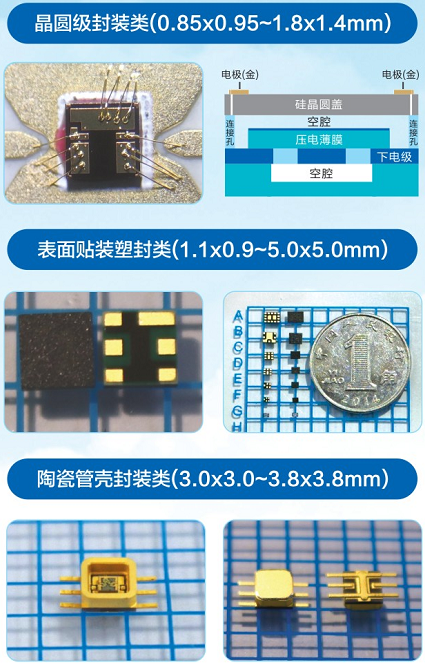
北斗卫通主推产品列表


4.电镀工艺:先进封装世界的“金属骨架”锻造者;
——微米尺度上精准“堆叠”,成就芯片性能的宏大飞跃
随着电子设备向着小型化、轻量化、高性能化及低成本方向飞速发展,集成电路芯片尺寸持续缩小,对封装技术提出了前所未有的挑战。能够实现高密度互联的凸点加工工艺脱颖而出,而电镀技术,正是塑造这些精密金属结构的核心工艺。从Flip Chip到3D堆叠,几乎所有先进封装形式都离不开它的身影。
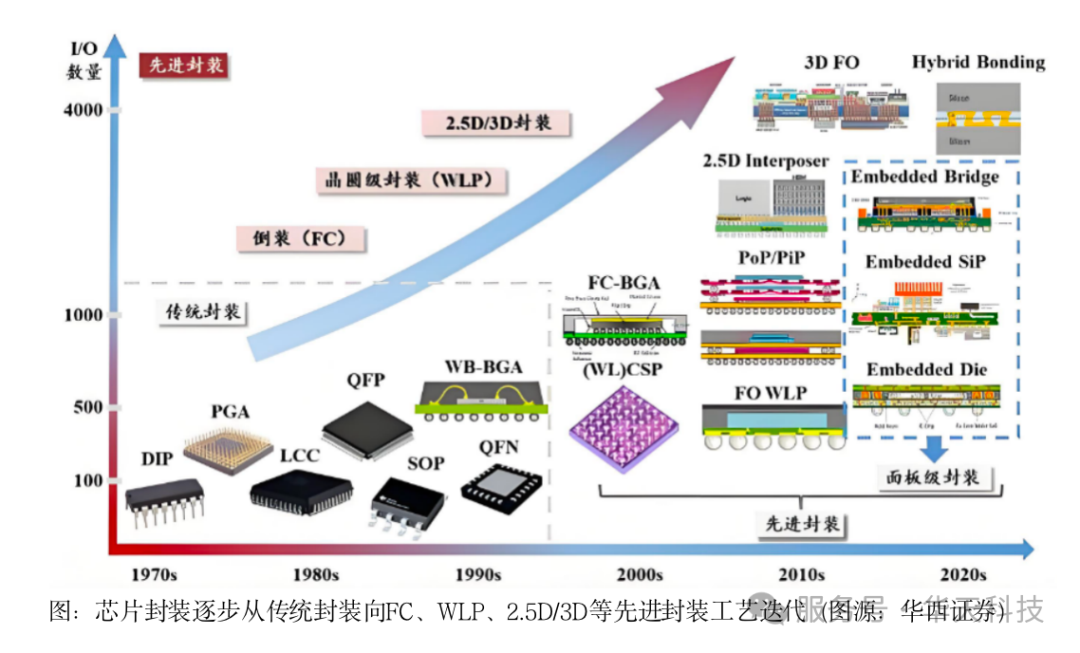
一、Flip Chip封装:坚固的“桥梁”与“基石”
在Flip Chip(倒装芯片)中,电镀扮演了两个关键角色:
1、打造“可焊”的基板:在基板焊盘上,通过电镀形成一层焊料可浸润的金属表面(如化学镍金),这确保了芯片上的凸块能够通过回流焊,牢固地“站立”在基板之上,构成可靠的连接。
2、构筑“铜柱”互联:直接在芯片上电镀出坚实的铜柱,作为连接芯片与外部世界的“金属桥梁”。这种结构能实现更小的节距、更高的互联密度和更优的电性能。
二、晶圆凸块:告别“飞线”,迎接“点焊”
传统的Wire Bonding(打线连接)如同用“飞线”连接芯片,而Bumping(凸块技术)则像精准的“点焊”。
通过在芯片的铝垫电极上直接电镀出铜柱、锡球或金凸块,它彻底取代了繁琐的打线。这不仅让互联速度更快、效率更高,更使得封装体积朝着“轻薄短小”迈出了革命性的一步。
三、晶圆级封装:芯片表面的“规划大师”
晶圆级封装直接在整片晶圆上进行加工,其中电镀技术至关重要:
1、重布线层:芯片的“内部立交”:通过电镀铜,在晶圆表面重新规划电路走线,将原本拥挤在芯片边缘的I/O焊盘,巧妙地重新分布到整个芯片表面。这极大地提升了芯片设计的灵活性。
2、凸块下金属层:牢固的“地基”:在铝焊盘上,先用电镀制作一层凸块下金属层。它如同高楼的地基,提供了良好的粘附性、阻挡性和导电性,确保上方的凸块坚如磐石。
四、2.5D/3D封装:垂直世界的“建造者”
当芯片的集成从平面走向立体,电镀技术更是大放异彩:
1、中介层:硅中的“交通枢纽”——在2.5D封装中,中介层承载着大量的硅通孔和重布线层。电镀技术负责构建这个复杂的立体交通网络,实现上下层芯片之间高效的数据传输。
2、硅通孔:贯穿楼层的“高速电梯”——这是3D封装的标志性技术。通过在硅片上刻蚀出深孔并用电镀铜完美填充,形成了垂直方向的互联通道,极大缩短了互联距离,提升了整体性能。
电镀工艺:微观世界的精准“雕刻”
下面以Bumping中的电镀为例介绍封装行业的电镀工艺。在Bumping工艺中,电镀的核心任务是在晶圆上“长出”尺寸精确、形状完美的金属凸块。这个过程就像一个在微观世界里进行的精准“堆叠”游戏,其背后的科学原理,主要基于经典的法拉第电解定律。
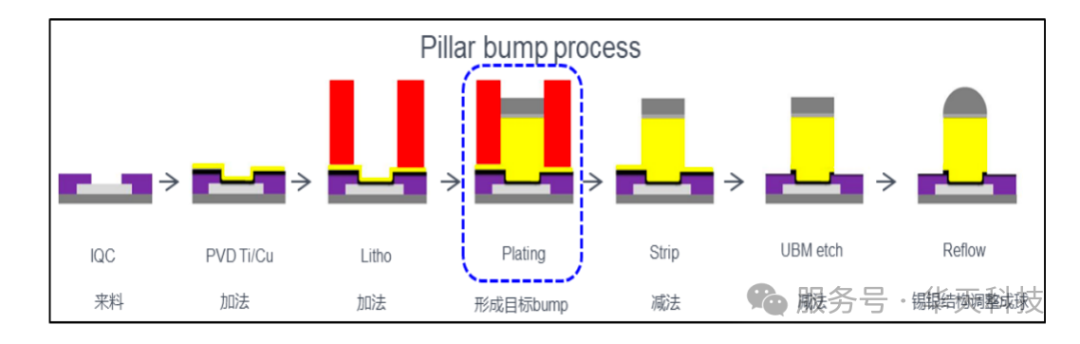
电镀原理——法拉第第一定律
对于单个电镀反应池,其基本规律可以概括为:阴极上析出的金属量,与通过的电流大小和通电时间成正比。用公式表示就是:M = K × I × t(其中M为金属质量,K为常数,I为电流,t为时间)。
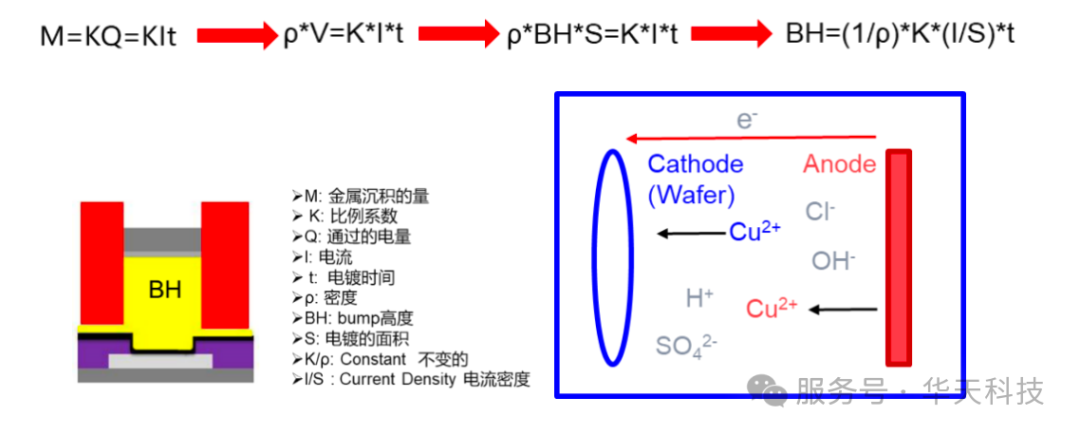
控制凸块高度的“双旋钮”:电流与时间
映射到Bumping工艺上,这就意味着:
电流密度:相当于控制金属离子沉积的“速度旋钮”。
电镀时间:相当于控制沉积过程的“时长旋钮”。
通过精确调控电流密度(金属离子沉积的“速度旋钮”)和电镀时间(沉积过程的“时长旋钮”),工程师就能精准控制每个微凸块的最终高度,确保成千上万的凸块都具有均一、可靠的尺寸。
电镀池内的微观“搬运”之旅
那么,电流是如何驱动金属“生长”在晶圆上的呢?这背后是一场生动的电化学“微电影”:
1、阳极的“奉献”:在电镀液中,可溶性的阳极(例如磷铜球)在电流作用下,会不断被氧化,释放出金属离子,补充到溶液中,如同为建筑持续供应“砖块”。
2、离子的“迁徙”:在电场力的驱动下,这些带正电的金属离子向带负电的阴极(即晶圆)移动。
3、阴极的“结晶”:当金属离子到达晶圆表面时,会获得电子并被还原成金属原子,逐层地、有序地沉积在特定的“种子层”上,最终“堆叠”成我们设计好的凸块结构。
看不见的“配方”:电镀液与添加剂
要实现高质量的电镀,光有电流和金属还远远不够。电镀液本身的“配方”至关重要,它通常包含:
金属盐:如硫酸铜,是提供“建筑原料”的主盐。
电解质:如硫酸,用于提高溶液导电性,保证电流畅通。
添加剂:这才是电镀工艺的“灵魂”。它们微量但作用巨大:
加速剂:加快材料凹陷处强力促进沉积。
抑制剂:能适度减缓凸块顶部的沉积速度。
整平剂:能促进凹陷处填充,确保凸块形状饱满、平整。
通过这些添加剂的协同作用,我们才能克服表面张力和电流分布不均带来的挑战,在微米尺度上“雕刻”出完美无瑕的金属凸块。
华天科技在先进封装电镀领域的布局与突破
作为中国领先的半导体封装测试企业,华天科技深刻把握电镀工艺在先进封装中的核心地位,并将其视为实现高密度、高性能互联的关键技术。公司近年来持续加大在晶圆级封装、TSV、Fan-Out等领域的电镀工艺研发,深耕fine pitch高密度电镀及深孔填充等关键技术,具备成熟的量产能力。
目前,华天科技致力于Flip Chip、晶圆级封装、2.5D/3D等先进封装产品中的电镀工艺进行研发攻坚,并不断取得突破。新的产品在应用端覆盖CIS、显示驱动、射频、存储等多个重要市场,根据国内外客户的需求提供高性能、高可靠性的封装解决方案。
面向未来,华天科技将继续深耕先进封装技术,推动电镀工艺向密度更高、高度均匀性更好,可靠性更稳定方向发展,持续强化在三维集成和系统级封装方面的技术布局,为中国半导体产业链的完善与自主可控贡献“华天力量”。










