11月20-21日,围绕“开放创芯,成就未来”主题,ICCAD-Expo 2025在成都西部国际博览城盛大举办。奕成科技携板级高密系统封测解决方案亮相本届大会并带来专题分享,全面展示了公司在板级封装领域的核心技术与应用成果。

行业趋势:板级封装拓展先进封装技术边界
随着摩尔定律趋缓与AI、高性能计算(HPC)算力需求的激增,先进封装技术正成为推动半导体产业持续演进的关键动力。聚焦这一趋势,奕成科技高级副总裁& CTO方立志在本次大会专题论坛发表《高端先进封装技术发展趋势》主题演讲,深入分享了板级封装技术的核心优势与发展前景,呼吁更多从业者参与,加速板级技术的市场渗透。
高端先进封装技术发展趋势
晶圆级封装(Wafer Level Package)正逐步向板级封装(Panel Level Package)转型,实现生产效率提升与成本优化,尤其在AI与HPC等高端芯片封装领域。
CoPoS(Chip on Panel on Substrate)板级技术已成为头部企业的战略高地,持续助力CoPoS 生态系统完善。
奕成科技板级封装CoPoS创新成果
量产突破:国内率先实现板级高密FOMCM产品量产,应用于AI、HPC产品。
前沿布局
■ Fan out Substrate:使用Fine RDL工艺,实现更高布线密度、更宽带宽;采用PI介质层,使产品更轻薄。
■ System on Panel:在面板上集成更多芯片、元器件,具备更高的产出效率与产出量。
■Glass Substrate:创新产品结构,以更小的基板尺寸,实现更高密度信号互连,提升良率同时有效控制成本。

奕成科技SVP & CTO 方立志在专题论坛发表演讲
EHIoP® 板级高密技术平台亮相
本次大会,奕成科技现场发布的全新技术矩阵——EHIoP® 板级高密技术平台,包含2D FO、2.xD FO、FOPoP、FC、Advanced SBT等多种先进封装技术,可覆盖小芯片/模组、中高端模组、高性能异构集成系统等多种类型的芯片产品,以满足算力需求激增对高端先进封装提出的全新挑战。

奕成科技EHIoP® 板级高密技术平台
此次大会重点展出EHIoP® 平台的代表产品:
2D FO
Die first
芯片5面 /6面包覆
无封装基板(Substrate-less)
可进行单芯片、多芯片系统集成
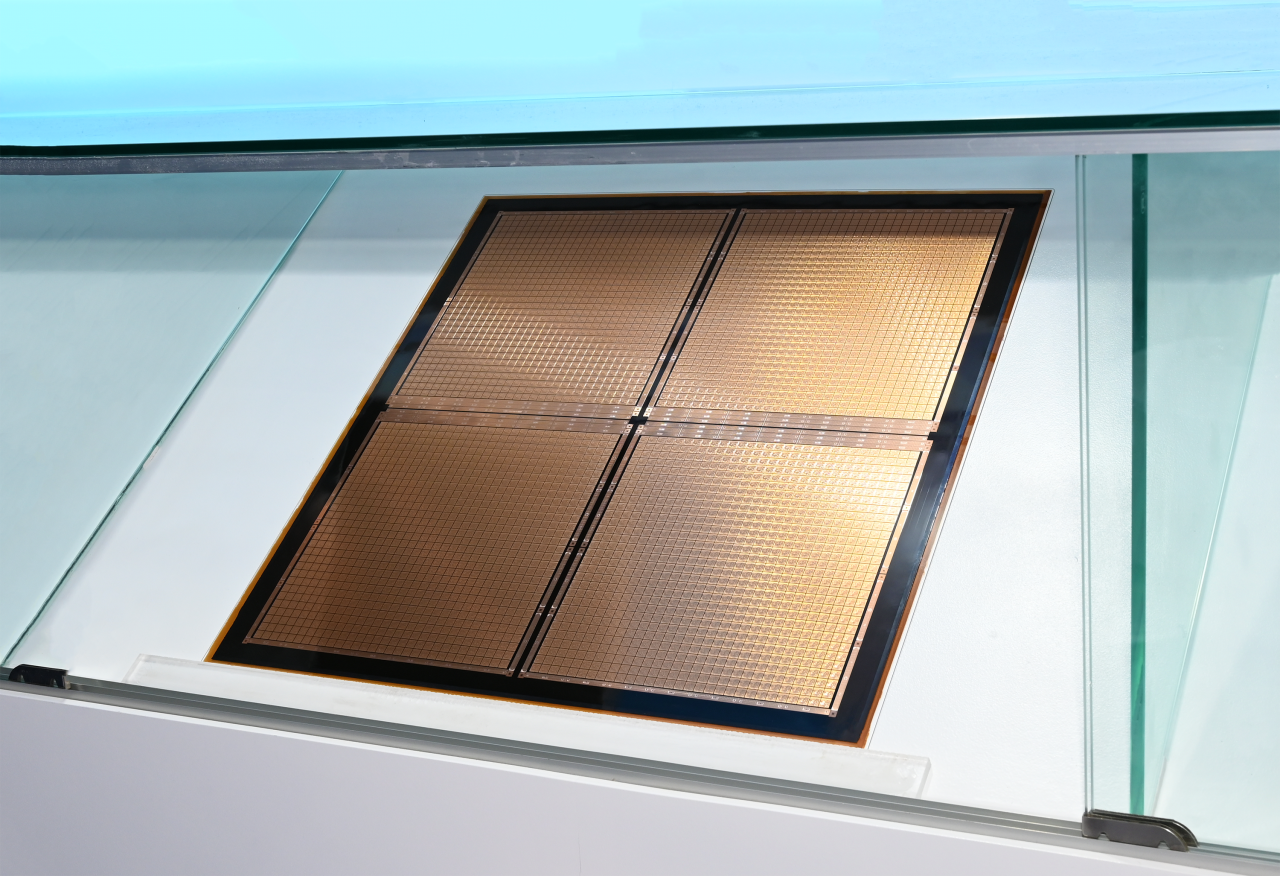
奕成科技2D FO封装产品
2.xD FO
RDL first,L/S : 2/2 μm,高密度互连
FO Size : 50*70mm
Substrate Size : 90*115mm
w/o or w. Si Bridge,优异的成本竞争力
灵活、高性能同构 /异构集成

奕成科技2.xD FO封装产品
此外,奕成板级高密系统封测工厂,配备20,000m²高标准洁净室自动化产线,目前已成熟运营,具备稳定量产能力,可提供封装设计、板级封装、最终测试等一站式服务,满足客户差异化需求。

奕成科技工厂及板级服务
未来,奕成科技将持续夯实技术、优化服务,致力于为客户提供更加高效卓越的板级高密系统封测解决方案,助力板级高端芯片产品规模化应用,协同产业链创新发展。










