芯观点──聚焦国内外产业大事件,汇聚中外名人专家观点,剖析行业发展动态,带你读懂未来趋势!

集微网报道,“异质封装的领域很广,台积电和日月光没真正互相竞争,而是各有长处、共创价值。”在1日举行的SEMICON论坛开展前的直播活动中,台积电卓越科技院士暨研发副总余振华如是说。
坐在他身边的是全球封测龙头、台积电长期合作伙伴日月光投控副总经理洪志斌。和乐融融的氛围,让人几乎想不起十年前余振华与日月光、矽品等就代工厂抢占先进封装市场针锋相对的过往。
自台积电2016年凭InFO拿下苹果A10处理器全部订单伊始,代工厂与封测厂在先进封装上的对峙愈发剑拔弩张。然而就在最近,台积电将CoWoS的“oS”流程委外OSAT的消息,给双方的关系带来了另一种可能。
TSV分水岭显现 “oS”让代工厂、OSAT握手言和?
尽管代工厂、封测厂对“先进”定义有所不同,但业内共识是,2.5D/3D封装正在成为先进封装的核心,顾名思义,其本质是将封装从水平互连拓展至垂直互连,其中的关键TSV(硅通孔),即是代工厂插队进场的关键所在。
TSV是连接硅晶圆两面并与硅基体和其他通孔绝缘的电互连结构,使得堆叠的裸晶或裸晶与基板(Substrate)之间实现上下层的互连,该技术的发明者即台积电,最早也是应用在台积电先进封装领域的首个重要研究成果CoWoS上。
在以CoWoS为代表的2.5D封装中,裸晶被并排放置在硅中介层的顶部,通过微凸块和硅中介层中的布线实现互连,上下层之间的互连则依靠在硅中介层打TSV实现,3D封装中则是直接裸片上打TSV。
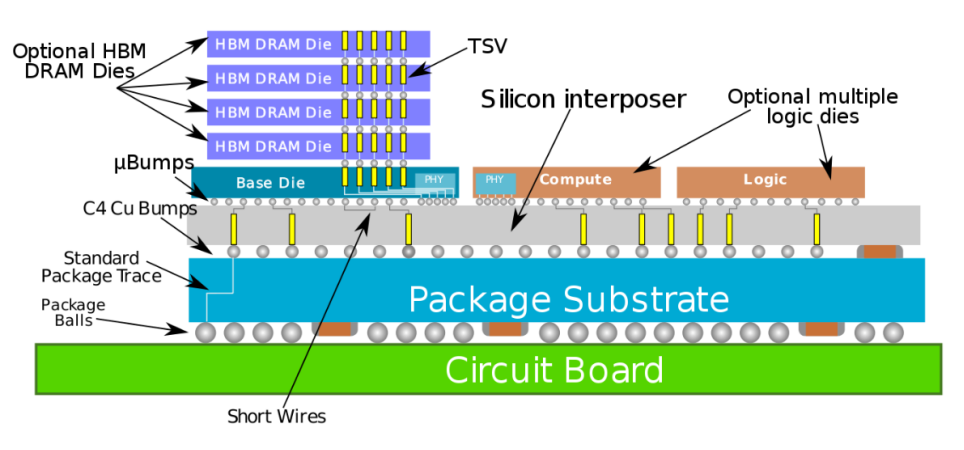
2.5D/3D封装;图源:Wikichip
鉴于代工厂在硅中介层(本质是晶圆)以及晶圆加工技术和成本上的天然优势,一些观点认为,以TSV技术为主导的垂直互连技术,大有成为代工厂、封测厂在先进封装领域的“分水岭”的趋势:
凭借垂直互连技术,代工厂将从高精度路径实现先进封装市场的抢占,封测厂则主动或被动地被固封在水平互连的领域,确立优势的最好办法是整合尽可能多的技术,提供尽可能灵活的服务。
变数出现在CoWoS的“oS”上,即芯片在完成Chip on Wafer(CoW)层级的封装后,与基板连接(On Substrate)的过程,由于其基于倒装等传统互连技术,所需人力更多、利润更低,成为代工厂和封测厂“握手言和”的契机。
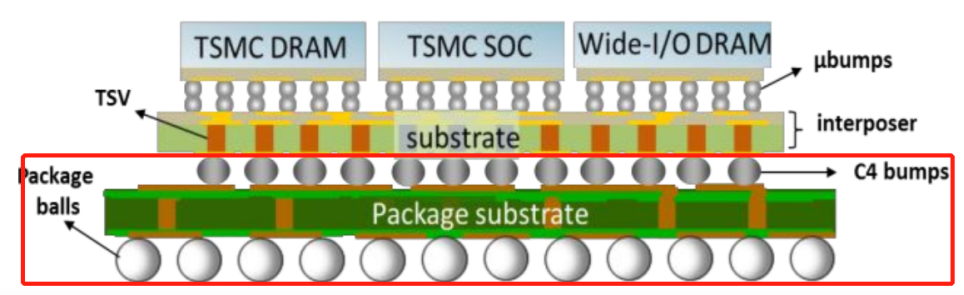
红框为“oS”流程;图源:IEEE
厦门云天董事长于大全教授对爱集微表示,随着业务量的增加,将先进封装流程中技术要求更低的环节外包给OSAT是合理的。“完成CoW层级封装说到底也还是芯片,仍需要连接基板,代工厂自己做需要很大产能。”
而相对于代工厂,封测厂的优势在于,在芯片倒装等基板层级的连接技术上经验积累丰富,并且产能优势显著,随之而来的是成本优势和更高的良率,与封测厂的合作,能够帮助代工厂降低投资,专注于精度上的拓展。
而对于部分观点提出的“良率追责”质疑,于大全认为不会对这种合作造成太大阻碍,对于封测厂来说,“oS”与传统封测业务相比,区别仅在于前者的裸晶“多了一层堆叠”而已,“哪段封装出问题就追责哪里。”
从封测厂的角度来说,2.5D/3D封装的大蛋糕近在眼前,但开发TSV技术成本过高,虽然“oS”是CoWoS中利润率最薄的一环,但相较于传统封测业务来说,利润率却相当可观,无疑将成为时下封测厂的优选。
“oS”蛋糕不易吃 代工厂谨慎委外低端流程
高利润率往往代表高技术壁垒,“oS”的高利润率同样也表明,并不是所有封测厂都有能力接下这一业务,而对于有能力做先进封装的代工厂们来说,也并不完全放心将大客户们的高端产品交予OSAT做后道封装。
据某台系代工厂业内人士向爱集微介绍,“oS”委外的模式,台积电在2019年为华为鲲鹏CPU代工时就曾采用,但对于一些带HBM(高带宽内存)的AI、GPU芯片并不适用。
究其原因,仍旧是对OSAT技术难度太大,“HBM造价高,做坏了赔偿责任太大。”据于大全分析,由于HBM的凸块间距可能更小,测试的过程或更加复杂,连接的硅中介层面可能更大,也使得“oS”流程复杂性提高。

HBM;图源:AMD
无缘这一类“oS”业务,阻止了封测厂进一步分食先进封装市场的可能。据爱集微此前报道引述某台系晶圆厂内部人士所说,已经有越来越多的芯片厂选择将CPU/GPU/TPU与一个或多个HBM组合在一起进行先进封装。
同时,就“oS”技术本身来说,也将决定封测厂是否能够顺利吃到这一块业务。据悉,目前的“oS”大多采用倒装技术,传统的倒装可应用到50μm或40μm的间距,但再往下走就可能会出现难以键合的问题。
JCET现场应用工程高级总监Nokibul Islam曾表示,通过大规模回流的传统倒装芯片在更窄的间距下的键合面临挑战。“标准回流工艺下可能会出现基板和芯片之间的整体热膨胀系数不匹配,从而导致更高的翘曲和芯片移位。”
这也解释了为何即使是整个流程工艺中利润率、技术要求最低的部分,台积电仍谨慎地将“oS”委外给了诸如日月光、安靠之类的国际一线封测厂,并且带HBM的产品的“oS”部分也仍由自己处理。
于大全认为,从未来的发展趋势来看,代工厂更有可能将一些低端的(例如Interposer比较小,线宽,pitch值较大)产品,在封测厂能力达到的情况下委外出去,但高端的(例如带HBM的)、有技术门槛的,仍然由自己处理。
“代工厂应该主要还是做芯片层面、即所谓‘Level-零级’封装,一级封装可以委外出去一部分,因为芯片量太大,如果代工厂自己做,投资和人力的效率不够高,利润率也肯定不如前段好。”
而除了CoWoS的“oS”流程以外,目前已经有越来越多的封测厂开始做RDL-first了,后者为扇出型封装的三大类型之一,于大全认为,代工厂今后也有可能将这一流程委外给封测厂。
值得一提的是,台积电的老对手三星电子,似乎也“嗅”到了这种模式的好处,旗下三星电机和安靠合作开发了2.5D封装解决方案“H-Cube”。虽然暂时没有证据表明安靠负责“oS”部分,但足够令人遐想。
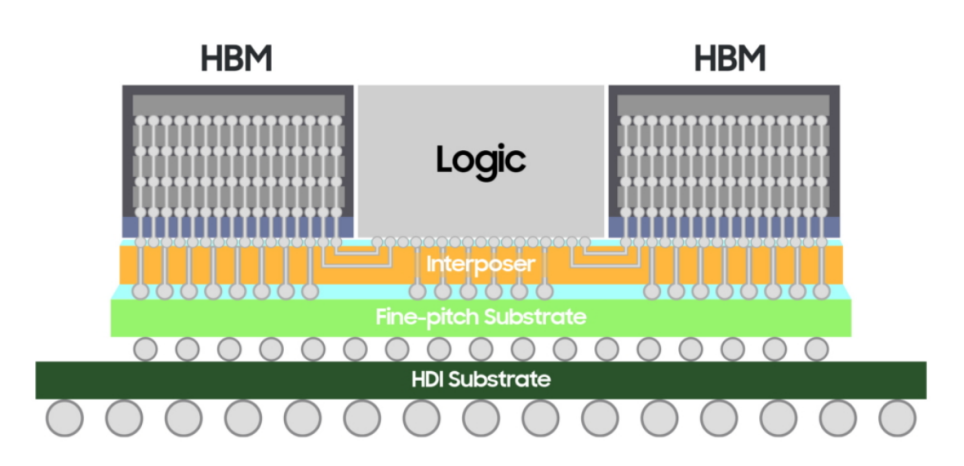
“H-Cube”;图源:三星电子
大陆封测厂难分一杯羹 垂直互连仍在探索
正如上文所说,由于类似“oS”的工艺流程仍有一定技术壁垒,不是所有封测厂都能分得这一杯羹,然而对于目前在全球封测环节具有相当市占的大陆封测厂来说,最大的拦路虎却不是技术。
据于大全推测,大陆某封测大厂已有做CoWoS的堆叠以及RDL-first的能力,另一封测巨头在Flip-Chip能力上也有一定优势,但两者在相关订单上均“两手空空”。
究其原因,一方面,台积电等头部代工厂对于委外仍然较为谨慎,倾向于交由日月光、安靠等全球头部大厂,另一方面,最有希望下单的大陆代工厂,则在先进封装领域还未达到2.5D/3D封装的水准。
后者或将是短期内大陆封测厂的最大指望。中芯国际资深副总裁张昕日前在IC WORLD大会上指出:“公司先进封装平台将在2.5D领域提供全覆盖Interposer方案,3D IC提供HBM/近存计算解决方案。”
除了头部封测厂之外,一些企业将资金集中投入在CoWoS领域,或专门做TSV技术,有机会进入这一市场,但前提是其技术要比现有的封测厂更先进,这也意味着非常高的资金投入,“没有几十亿做不到。”
与此同时,封测厂们也在不断攻克新的垂直互连技术。例如,长电科技计划明后年面世的XDFOI系列,较2.5D TSV封装具有更灵活的设计架构、更低的成本、更好的性价比以及更高的可靠性。
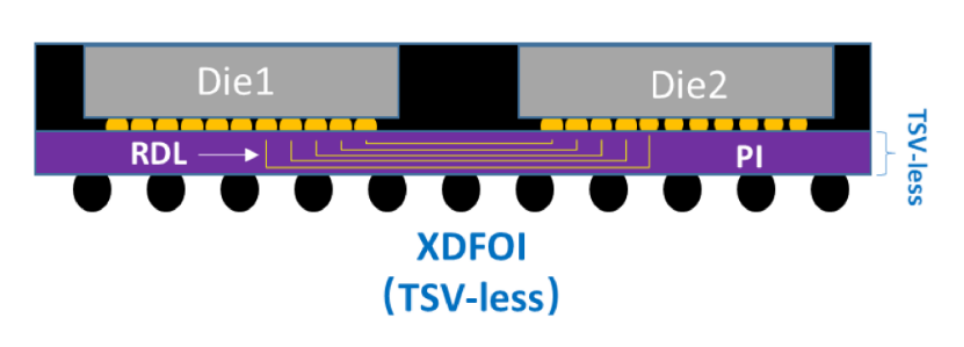
来源:semiengineering
此外,长电科技还推出了无硅通孔扇出型晶圆级高密度封装技术,使用Stacked VIA替代TSV以解决后者居高不下的成本以及仍然困扰代工厂的良率问题,可实现多层RDL再布线层,2/2um线宽间距,40um级窄凸块互联。
于大全也认为,将TSV作为代工厂和封测厂在先进封装领域的分水岭还为时过早。据其介绍,TSV将出现标准化的趋势,封测厂未来也有能力做到裸晶的堆叠,“只是说有没有前端厂来支持封测厂做这一方面的业务。”
另外就TSV本身来说,也有高端低端之分,虽然像台积电那样直径很小、pitch值很小的TSV,封测厂暂时没有能力做,但对于一些低端的产品、封测厂有能力去做的,还是趋向于分工给封测厂,“因为产能要求太高。”
不过,这并不意味着代工厂和封测厂之间没有技术壁垒。于大全分析,两者之间存在的技术之“墙”有两个:一是小于1um的线宽,二是在有源芯片上做TSV、在芯片加工过程中做TSV,两者均为封测厂暂时无法做到的。
写在最后
“封测厂已经跟不上晶圆代工的脚步了。”2011年,刚刚从张忠谋手中接手先进封装具体任务的余振华,在媒体上与日月光、矽品等封测大厂相互“呛声”,双方就先进封装的对峙,一度剑拔弩张。
十年后,前有台积电将“oS”委外代工,后有余振华强调“产业链上下游共同合作”、“与封测厂无竞争”的态度一百八十度骤变,不禁让外界猜测这是否预示着行业分工在先进封装领域已走向新的业态。
然而,从余振华当天的全部言论中,仍然暗藏其他意味。比如其强调的异质整合面临的两大挑战——成本控制、精准制程控制,两者均解释了台积电委外“oS”的根本原因,即先进封装前、后道工艺的不统一。
这可能表明,余振华或者说是台积电在“封测厂先进封装落后于代工厂”的观点从未改变。另一方面,对封测厂来说,接手“oS”或许是其在先进封装领域暂时的选择,但大厂却仍未停止向垂直互连探索的步伐。
技术的推进,往往会推动产业链生态的质变。就如先进封装的到来,模糊了代工厂和封测厂的界限,让原本泾渭分明的上下游分工关系变得水乳交融。而这种竞争和合作共存的状态,预计仍将在很长一段时间内持续。
(校对/holly)


 登录
登录







