集微网消息,2018年随着全球新建晶圆厂快速增加并逐渐投入使用,半导体设备市场也水涨船高。市场研究机构数据显示,2018年全球半导体制造设备销售额预计将达到620.9亿美元,同比增长10.97%,再创新高。然而,去年下半年以来,全球半导体市场增长疲软,半导体设备出货也呈现下滑,产业景气持续走弱。SEMI统计今年半导体厂家投资到前段工序的设备将会受到存储半导体泡沫崩溃的影响,比2018年减少14%至530亿美元。

KLA首席营运官Rick Wallace在1月29日举行的2019财年第二季度财报电话会议上表示,由于来自内存市场的支出显著下降,今年半导体设备(WFE)投资将回落,不过,他认为,尽管近期半导体市场疲软影响了WFE投资,但由于更大、更多样化的半导体器件需求以及更多市场驱动的晶圆厂产能规划驱动,该市场的长期增长动力仍然强劲。
Rick Wallace指出,内存市场支出下降,是移动应用需求疲软和数据中心市场回落的结果,然而,客户预计将采取更加理性而严谨的投资态度,供应和需求会随着时间的推移而重新平衡。另一方面,与内存市场相比,先进工艺的代工厂和逻辑制程投资开始增长,预计2019年将继续保持增长势头,KLA预见了客户通过平衡全年投资来向先进工艺节点过渡并导入EUV光刻。对KLA而言,由于裸晶圆市场中更严格的晶圆清洁度、几何尺寸推动,以及7纳米掩膜引入EUV及非EUV工艺,晶圆及掩膜检测等相关的业务预计将在2019年保持强劲增长。
三大新举措推动未来增长
2018年度,KLA营收达到43亿美元,其中第四季度中国大陆市场营收占比达到23%,已经与台湾地区并列第一。
为推动未来持续增长,KLA近期宣布了三大举措。KLA企业传播高级总监Becky Howland指出,首先,KLA全球在今年初已正式从KLA-Tencor更名为KLA,寓意“Keep Looking Ahead”,配合最新的全球市场发展战略;第二,2019年二月KLA对Orbotech的收购案顺利完成,如今的KLA在全球拥有超过1万名员工,在中国大陆的17个城市设有分支机构来提供本土化的技术、销售支持服务。商业版图也进一步拓展,涵盖了PCB、平板显示等。第三,KLA在不断努力,将Fab端的制程控制技术进一步拓展到了汽车电子产品,关乎驾驶安全的电子产品更重要的是可靠性控制,传统的检测排除方案已经不足以满足目前的要求,KLA自主开发的在线零件平均测试方案 (Inline PAT: I-PAT)为日益提高的可靠性需求提供了创新性的解决方案。
KLA于今年2月完成了对Orbotech 34亿美元的并购。Becky Howland介绍,Orbotech 2018财年营收超过10亿美元,极大地完善了KLA的产品阵容,包括印刷电路板(PCB)、平板显示器、半导体制造和封装等。两家公司合并后营收超过了50亿美元,过去四年里研发投入超过26亿美元,在半导体设备领域居领先地位。
最后,汽车市场是KLA今后布局的重中之重。
研究I-PAT技术实现精度更高的汽车芯片缺陷检测
随着自动驾驶技术越来越成熟,汽车中所使用的半导体芯片越来越多,也更加复杂。预计到2030年,新的电动车和无人驾驶汽车的50%成本将是电子元件。显然半导体是汽车革命的一个驱动力,但是它也带来了巨大的风险。
Becky Howland表示,如果将随机故障(18%),系统故障(29%)和测试覆盖率故障(14%)加总,大约有47%的零公里故障是源自于电子元件缺陷。因此,相比消费电子,零缺陷对于汽车行业至关重要,因为事关人身安全,汽车电子对半导体工艺的要求几乎是“零缺陷”。“在制造过程中,检测和量测变得越来越重要,越早发现问题所在,就越能在问题扩大之前处理,可挽回的损失越大。”Becky Howland强调,“KLA通过先进检测和量测技术来为芯片制造‘保驾护航’,并提升产品良率、降低成本。”
传统上,业界检测芯片的各种缺陷有多种检测方法,最常见的是零件平均测试法(G-PAT, (Geographic Part Average Testing))。Becky Howland指出,潜在缺陷-latent defect(影响芯片可靠性的缺陷)和致命缺陷(影响良率的缺陷)有所不同。一些潜在的可靠性的缺陷是最严重的,它可能到了用户驾驶汽车时才暴露出来,随着环境如电子迁移、张力迁移、振动、湿度、热量等因素影响才被激活,从而使潜在缺陷导致芯片失效,进而发生严重的事故。传统的G-PAT方法可能就无法检测出潜在缺陷。
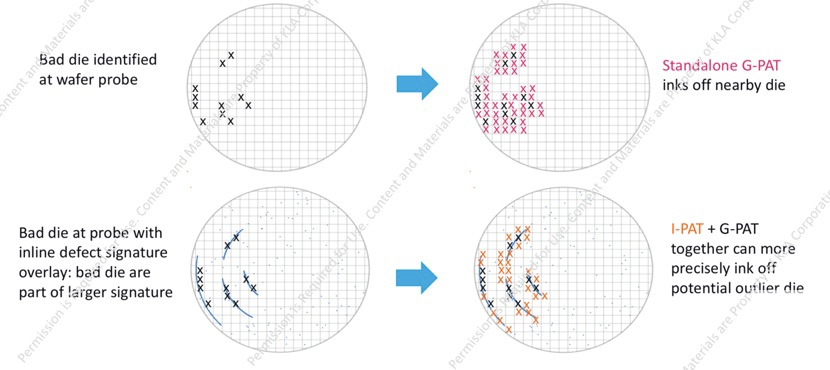
对此,KLA正在研究在线检测数据辅助芯片筛选技术,并正在为I-PAT (在线零件平均测试 Inline PAT,缩写:I-PAT)申请专利。Becky Howland介绍,当芯片被制造后,需要通过晶圆探针或电性能异常芯片测试(e-test)来确定芯片的好坏。左边的图就是通过电信检测以后,打X的是不好的芯片。传统方法就是G-PAT,所做的是移除坏的芯片,但在其附近的芯片也可能都不是好的,因为只能检测到致命缺陷,没有办法检测潜在缺陷,所以为了安全起见,附近所有的芯片也要被丢弃。右上图打X芯片的旁边,可疑的芯片用红X表示,把这些全部拿掉,不要让这些不好的或者有可能不好的芯片往下游走,这种不是厂家愿意看到的情况,把不好的芯片或者有可能不好的芯片拿掉。但这种方式就有可能把好的芯片丢弃,对厂家来说这些都是成本。
KLA开发出了更先进的I-PAT技术,并且通过牺牲较少的良率,而显著提升可靠性。它基于左上图,看到一些不好的芯片,根据在线检测出来的迹象,看到四条迹象,把这个与G-PAT方法检测出来的坏的芯片(红X)重叠,然后把这些重叠的部分有问题的去掉。这样可以看到,右下图那些有可能坏的芯片比右上图少很多,这样就减少了好的芯片被去掉的数量。
总而言之,I-PAT技术利用基于硬件(检测设备)和软件(数据分析)寻找那些在总体生产中的多个常规检测中累计缺陷异常多的芯片。这些异常芯片从统计上来讲更可能包含需要消除的潜在可靠性缺陷。I-PAT结果可以与电性能异常芯片测试相结合,改进芯片的整体“通过/不通过”决策。(校对/Oliver)


 登录
登录